當(dāng)前,我國(guó)消費(fèi)電子行業(yè)發(fā)展迅速,已成為全球生產(chǎn)和消費(fèi)的主要地區(qū)。隨著電子產(chǎn)品小型化和多功能化的發(fā)展,人們對(duì)電子芯片也提出越來越高的要求。電子芯片制造起源和發(fā)展都在國(guó)外,自電子芯片生產(chǎn)引進(jìn)國(guó)內(nèi)后,國(guó)內(nèi)芯片生產(chǎn)相關(guān)材料也引起了極大重視。在電子芯片制造工藝流程中,底部填充膠起著至關(guān)重要的作用。雖然用量較少,在芯片制造成本中所占的比例較低,但目前其市場(chǎng)基本依賴進(jìn)口,國(guó)內(nèi)目前存在較大缺口。
在電子封裝過程中,電子元器件是由不同線膨脹系數(shù)的材料組成。在熱循環(huán)下,由于膨脹尺度不同會(huì)產(chǎn)生熱應(yīng)力差,進(jìn)而產(chǎn)生相對(duì)位移,導(dǎo)致整個(gè)元件失效,而底部填充是避免此現(xiàn)象產(chǎn)生的有效方式。
底部填充膠,又稱為底填膠、底部填充劑、底填劑和底充膠等,即在封裝時(shí)滲入到芯片、焊柱和基板之間形成可靠粘接,分散芯片在受到機(jī)械作用和熱循環(huán)作用時(shí)其焊點(diǎn)處所受的應(yīng)力,避免開焊和不良焊點(diǎn)的產(chǎn)生。此外,底部填充膠還可以起到保護(hù)焊點(diǎn)免受濕氣、離子污染物等周圍環(huán)境影響的作用。底部填充膠極大地提高了封裝穩(wěn)定性和產(chǎn)品的使用壽命,目前主要用于筆記本電腦、USB、手機(jī)等手提電子產(chǎn)品的線路板組裝。一般將底部填充膠分為芯片級(jí)底部填充(CLU)和 PCB 板級(jí)底部填充(BLU),其中芯片級(jí)底部填充對(duì)封裝膠要求更加嚴(yán)格。
電子芯片高集成化和高性能化的發(fā)展,對(duì)底部填充膠的性能提出了更高要求。根據(jù)工藝和使用性能,底部填充膠需要具備易操作、快速流動(dòng)、快速固化、長(zhǎng)使用壽命、高粘接強(qiáng)度和低模量的基本特點(diǎn),同時(shí)還要滿足填充性、兼容性和返修性等。
可靠性:經(jīng)過溫濕、冷熱沖擊和機(jī)械沖擊后,電性能和粘接性能穩(wěn)定。底部填充膠的熱膨脹系數(shù)(CTE)、玻璃化轉(zhuǎn)變溫度(Tg)以及模量系數(shù)(Modulus)等,要與 PCB 基材、器件的芯片和焊料合金等因素進(jìn)行匹配,膠粘劑的 Tg 對(duì) CTE 有著重要的影響。當(dāng)溫度低于 Tg 時(shí),CTE 較小,反之則 CTE 急劇增加。模量系數(shù)為物質(zhì)的應(yīng)力與應(yīng)變之比,模量是膠粘劑固化性能的重要參數(shù),模量較高則表示膠粘劑的粘接強(qiáng)度與硬度較好,但也代表著膠粘劑固化后殘留的應(yīng)力較大。
操作性:膠粘劑的流動(dòng)性與錫球間距、錫球尺寸有關(guān)。不同間隙高度和流動(dòng)路徑,導(dǎo)致流動(dòng)時(shí)間也不同,如需保證快速完全填充,則要求膠粘劑黏度低、流動(dòng)快;但黏度也不能過低,否則生產(chǎn)過程中容易滴膠。一方面填充膠的表面張力、接觸角、黏度和硬化反應(yīng)可對(duì)填充膠在芯片和電路底板之間流動(dòng)產(chǎn)生影響,其中黏度為最主要因素,溫度則是影響填充膠黏度的重要因素;另一方面焊球點(diǎn)的布置密度和邊緣效應(yīng)對(duì)芯片和電路底板之間流動(dòng)也有一定影響,焊球點(diǎn)之間縫隙的寬度、焊球點(diǎn)的直徑、芯片與電路底板之間的縫隙高度決定了焊球點(diǎn)產(chǎn)生的影響。
效率性:底部填充膠的固化溫度應(yīng)適當(dāng),以保護(hù)主板上的其他電氣器件及焊點(diǎn)。同時(shí),固化速度要快,過長(zhǎng)的固化時(shí)間會(huì)影響流水線作業(yè)的效率。此外,固化方式需要滿足大批量生產(chǎn)需求。
耐熱性:膠粘劑的線脹系數(shù)(CTE)與基材線脹系數(shù)要相匹配。且僅有材料的 CTE 較小時(shí),Tg 對(duì)熱循環(huán)疲勞壽命才有一定影響,因?yàn)楫?dāng)材料溫度高于 Tg 和低于 Tg 時(shí),其 CTE 變化差異很大。同時(shí)相關(guān)試驗(yàn)表明,當(dāng) CTE 較低時(shí), Tg 越高熱循環(huán)疲勞壽命就越長(zhǎng)。電子元器件在工作時(shí)會(huì)發(fā)熱,需要固化物有良好的耐熱性。
耐腐蝕性:低氯離子含量和金屬離子含量均可減緩微線路腐蝕。
兼容性:焊點(diǎn)周圍存在錫膏殘留的助焊劑,如果底部填充膠與殘留的助焊劑不兼容,會(huì)導(dǎo)致底部填充膠無法有效固化。
可檢驗(yàn)性:固化前后顏色明顯變化,或通過紫外照射出現(xiàn)顏色變化,方便檢驗(yàn)固化或填充情況。
返修性:底部填充膠通常要求具有可返修性,因?yàn)樵诰€路板組裝完成后,如在整板測(cè)試中發(fā)現(xiàn)芯片不良等情況,需對(duì)芯片進(jìn)行返修。為降低成本、避免廢品的產(chǎn)生導(dǎo)致整個(gè)電路板的報(bào)廢,對(duì)底部填充膠的可返修性要求與日俱增。
功能性:要求低應(yīng)力、低 CTE、與錫膏兼容性、絕緣電阻及良好填充效果(無氣泡、空洞)等。
電子級(jí)封裝涉及的粘接基材均為精密器件,具有尺寸小、功能化(介電性能、力學(xué)性能、耐腐蝕性能、導(dǎo)熱等)和所處環(huán)境非常規(guī)(如高溫高濕、溫度變化、應(yīng)力沖擊等)等特點(diǎn)。
3.1 膠粘劑在固化中收縮產(chǎn)生的應(yīng)力問題
膠粘劑在固化中由于鍵長(zhǎng)改變會(huì)產(chǎn)生收縮問題(一般為 3.5~1.4 ?),膠粘劑從液體到凝膠狀態(tài)、到達(dá)到 Tg、再到完全固化,期間受凝膠、固化溫度和 Tg 的影響,不同階段的狀態(tài)都不相同,影響因素較多且缺乏過程的表征手段。由于整個(gè)過程中會(huì)產(chǎn)生不同程度、不同原因的收縮,產(chǎn)生較大的內(nèi)應(yīng)力,所以容易導(dǎo)致粘接失效,包括膠層失效(裂紋)、粘接失效(脫附)和器件失效(器件受力變形或破壞)。
目前減小材料的固化收縮率主要是通過添加填料的方式,但其調(diào)節(jié)能力有限,若大量使用,會(huì)導(dǎo)致黏度、模量等大幅度變化,反而不利于底部填充。因此,底部填充膠的應(yīng)力收縮問題是目前該類材料應(yīng)用的主要問題之一。
3.2 膠粘劑的線脹系數(shù)與基材的線脹系數(shù)匹配問題
由于電子器件應(yīng)用溫度隨著使用環(huán)境的變化而變化,導(dǎo)致同類器件可能在低溫下應(yīng)用,也有可能在高溫下應(yīng)用。另外由于電子器件發(fā)熱等情況帶來的局部高溫環(huán)境不同,甚至固化過程也會(huì)發(fā)生溫度的改變。膠粘劑的 CTE 一般比所粘接器件的CTE 要高,當(dāng)溫度改變時(shí),會(huì)在粘接界面產(chǎn)生應(yīng)力,溫度變化量大時(shí)甚至?xí)?dǎo)致局部產(chǎn)生應(yīng)力開裂。
目前常用的方法是通過添加低膨脹填料進(jìn)行改進(jìn),對(duì)填料的要求也比較高,如小粒徑會(huì)導(dǎo)致黏度上升,填充時(shí)粒徑不超過縫隙的 1/4,一般光柵陣列間相距 25 μm,因此需要膠粘劑的黏度較低且容易流動(dòng)填充。這就帶來了因填料引起的黏度不匹配與CTE 矛盾的難題。膠粘劑的導(dǎo)熱系數(shù)不高,導(dǎo)熱系數(shù)達(dá)到 2.8 W/(m·K)很困難,可通過加入填料,改變其數(shù)目比和尺寸比進(jìn)行提升,但提高程度也會(huì)影響膠粘劑的其他工藝特性。因此集多種矛盾為一身的體系如何尋求突破是一大難點(diǎn),目前國(guó)外的原料制造水平較高,有專注于通過研究特種結(jié)構(gòu)的環(huán)氧樹脂來解決此問題。
3.3 膠粘劑純度控制和質(zhì)量穩(wěn)定性問題
底部填充膠主要成分為環(huán)氧樹脂,由于大部分環(huán)氧樹脂合成是通過環(huán)氧氯丙烷開環(huán)閉環(huán)的工藝路線,會(huì)產(chǎn)生含氯副產(chǎn)物。而氯離子在電子器件的應(yīng)用過程中會(huì)腐蝕基材,導(dǎo)致粘接失效,氯離子遷移也會(huì)影響電子器件的光電性能。由于在合成階段難以控制環(huán)氧樹脂中氯的源頭問題,要獲得低氯離子含量環(huán)氧樹脂就需要進(jìn)行純化,即使用將已合成樹脂進(jìn)行再反應(yīng)的方法進(jìn)行提純,從而達(dá)到電子級(jí)的使用要求(氯離子含量<50 g/kg)。目前,以日本為代表的國(guó)外企業(yè)在電子級(jí)環(huán)氧樹脂方面發(fā)展迅速但對(duì)外壟斷,而國(guó)內(nèi)高純低氯環(huán)氧樹脂發(fā)展水平較低,存在產(chǎn)品純度不高和質(zhì)量穩(wěn)定性差等問題,極大地限制了環(huán)氧樹脂在電子領(lǐng)域的應(yīng)用。
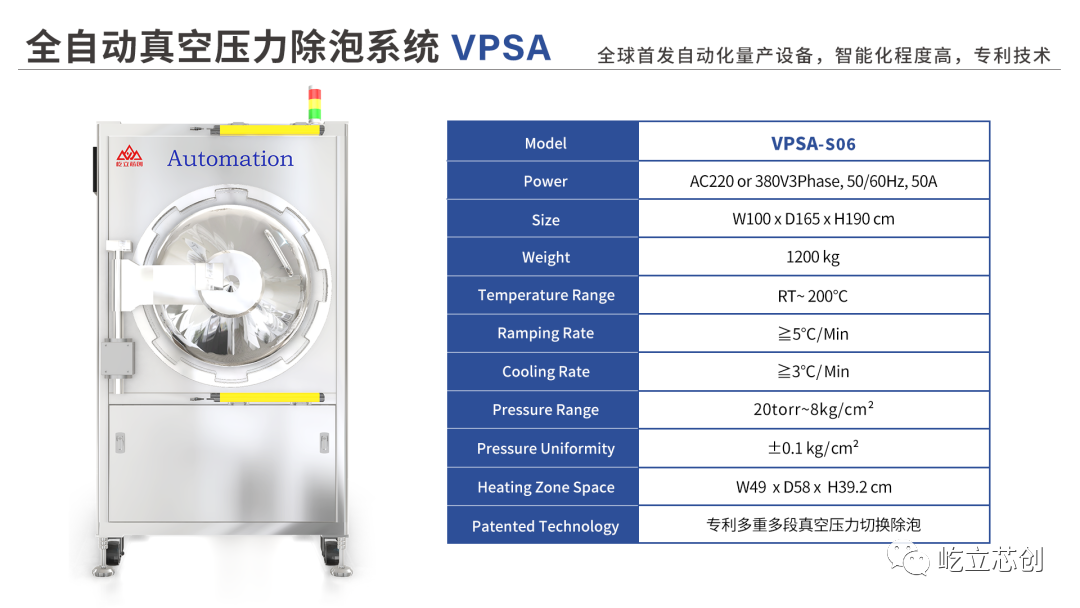
獨(dú)家專利除泡能力,全球首發(fā)自動(dòng)化設(shè)備,智能化系統(tǒng)布設(shè)可對(duì)接OHT-AGV等自動(dòng)化產(chǎn)線設(shè)備。
采用多重多段真空/壓力切換系統(tǒng),根據(jù)工藝及材料需求設(shè)計(jì)最佳除泡方案,輔助以微壓力控制系統(tǒng);
固化品質(zhì)高采用雙腔體、雙溫控系統(tǒng),屹立芯創(chuàng)先進(jìn)控溫技術(shù),控溫精度高達(dá)±1°C,可實(shí)時(shí)監(jiān)控溫度并生成溫度曲線;爐內(nèi)溫度均勻性好,固化品質(zhì)高,一致性好;
更可靠結(jié)構(gòu)設(shè)計(jì)及零件經(jīng)上百次優(yōu)化迭代,結(jié)構(gòu)更簡(jiǎn)潔、實(shí)用,不易出故障;先進(jìn)的零件性能更加出色,使設(shè)備的運(yùn)行穩(wěn)定性更強(qiáng),滿足連續(xù)式、大批量生產(chǎn)要求;
采用智能化系統(tǒng)布設(shè)可對(duì)接OHT-AGV等自動(dòng)化產(chǎn)線設(shè)備可對(duì)接MES系統(tǒng),保證生產(chǎn)安全及產(chǎn)品良率。
屹立芯創(chuàng)本著優(yōu)先讓客戶成功的經(jīng)營(yíng)理念,一直致力于除泡品類設(shè)備的研發(fā),經(jīng)過20多年的技術(shù)經(jīng)驗(yàn)積累,目前已成功量產(chǎn)符合多種工藝材料需求的除泡設(shè)備,實(shí)現(xiàn)了完全國(guó)產(chǎn)化并在多個(gè)國(guó)家或地區(qū)廣泛使用,成為中國(guó)封測(cè)領(lǐng)域解決除泡問題的排頭兵。

———————
獲取封裝測(cè)試服務(wù)
電話:4000202002;13327802009
地址:南京市江北新區(qū)星火北路11號(hào)
官網(wǎng):
郵箱:info@elead-tech.com