
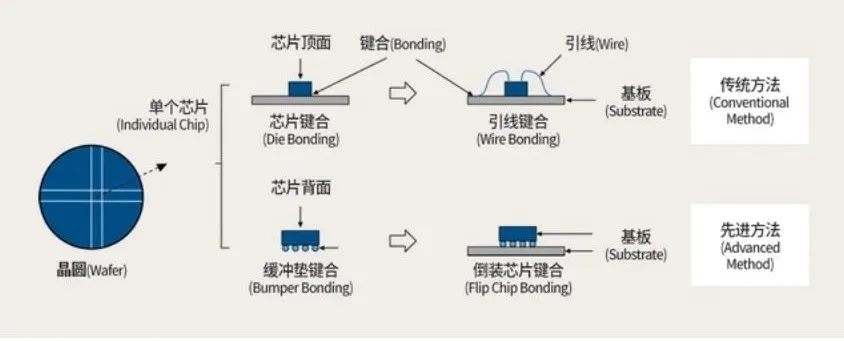
在半導(dǎo)體工藝中,“鍵合”是指將晶圓芯片固定于基板上。鍵合工藝可分為傳統(tǒng)方法和先進(jìn)方法兩種類型。傳統(tǒng)方法采用芯片鍵合(Die Bonding)(或芯片貼裝(Die Attach))和引線鍵合(Wire Bonding),芯片鍵合(Die Bonding),是將芯片固定到基板(substrate)上的一道工藝。引線鍵合(wire bonding)則作為芯片鍵合的下道工序,是確保電信號傳輸?shù)囊粋€過程。
而先進(jìn)方法則采用IBM公司在1960年研制開發(fā)出在芯片上制作凸點的倒裝芯片焊接工藝。以95Pb5Sn凸點包圍著電鍍NiAu的凸球。后來制作PbSn凸點,使用可控塌焊連接(Controlled collapse Component Connection, 簡稱C4技術(shù)),該技術(shù)最初為自己的大型計算機(jī)主機(jī)所開發(fā)的一種高可靠的封裝技術(shù)。C4芯片具有優(yōu)良的電學(xué)、熱學(xué)性能,封裝疲勞壽命至少提高10倍以上,倒裝芯片鍵合技術(shù)將芯片鍵合與引線鍵合相結(jié)合,通過芯片上的凸點直接將元器件朝下互連到基板、載體或者電路板上。
兩種芯片鍵合方式優(yōu)勢對比
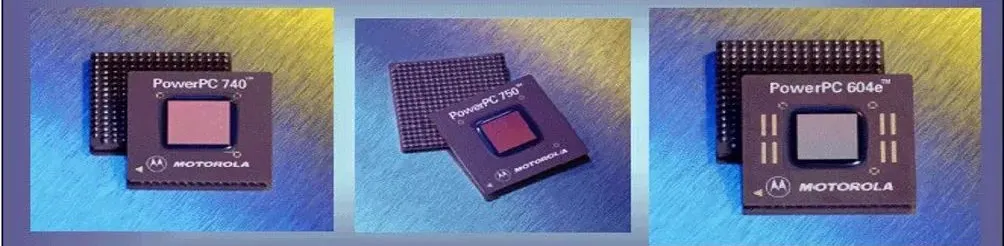
倒裝芯片元件主要用于半導(dǎo)體設(shè)備,有些元件,如無源濾波器,探測天線,存儲器裝備也開始使用倒裝芯片技術(shù),由于芯片直接通過凸點直接連接基板和載體上。因此,更確切的說,倒裝芯片也叫DCA(Direct Chip Attach),下圖中CPU及內(nèi)存條等電子產(chǎn)品是最常見的應(yīng)用倒裝芯片技術(shù)的器件。
下圖是內(nèi)存條中存儲芯片通過倒裝技術(shù)與線路板連接,芯片與電路板中間通過填充膠固定。
在典型的倒裝芯片封裝中, 芯片通過3到5個密耳(1mil=25um)厚的焊料凸點連接到芯片載體上,底部填充材料用來保護(hù)焊料凸點。
下圖是一張典型的倒裝連接圖,芯片與下方的基板采用倒裝方式連接:

在芯片鍵合過程中,首先需在封裝基板上點上粘合劑。接著,將芯片頂面朝上放置在基板上。與此相反,倒裝芯片鍵合則是一種更加先進(jìn)的技術(shù),首先,將稱為“焊球(Solder Ball)”的小凸塊附著在芯片焊盤上。其次,將芯片頂面朝下放置在基板上。在這兩種方法中,組裝好的單元將經(jīng)過一個被稱為溫度回流(Temperature Reflow)的通道,該通道可隨著時間的推移調(diào)節(jié)溫度,以熔化粘合劑或焊球。然后,在其冷卻后將芯片(或凸塊)固定到基板上。
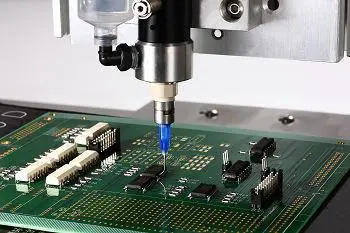
環(huán)氧樹脂密封保護(hù)加固作用的前提是膠水已經(jīng)固化,而焊點周圍有錫膏中的助焊劑殘留,如果底部填充膠與殘留的助焊劑不兼容,導(dǎo)致底部填充膠無法有效固化,那么底部填充膠也就起不到相應(yīng)的作用了,因此,底部填充膠與錫膏是否兼容,是底部填充膠選擇與評估時需要重點關(guān)注的項目。
底部填充膠除起加固作用外,還有防止?jié)駳狻㈦x子遷移的作用,因此絕緣電阻也是底部填充膠需考慮的一個性能。底部填充膠主要的作用就是解決BGA/CSP芯片與PCB之間的熱應(yīng)力、機(jī)械應(yīng)力集中的問題,因此對底部填充膠而言,很重要的可靠性試驗是溫度循環(huán)實驗和跌落可靠性實驗。

使用環(huán)氧樹脂進(jìn)行芯片鍵合時,可將極少量環(huán)氧樹脂精確地點在基板上。將芯片放置在基板上之后,通過回流(Reflow)或固化(Curing),在150°C至250°C的溫度條件下使環(huán)氧樹脂硬化,以將芯片和基板粘合在一起。此時,若所使用環(huán)氧樹脂的厚度不均勻,則會因膨脹系數(shù)差異而導(dǎo)致翹曲(Warpage),從而引起彎曲或變形。
正因為如此,一種使用晶片黏結(jié)薄膜(Die Attach Film, DAF)的先進(jìn)鍵合方法成為近年來的首選方法。盡管DAF具有價格昂貴且難以處理的缺點,但卻易于掌握使用量,簡化了工藝,因此使用率正在逐漸增加。
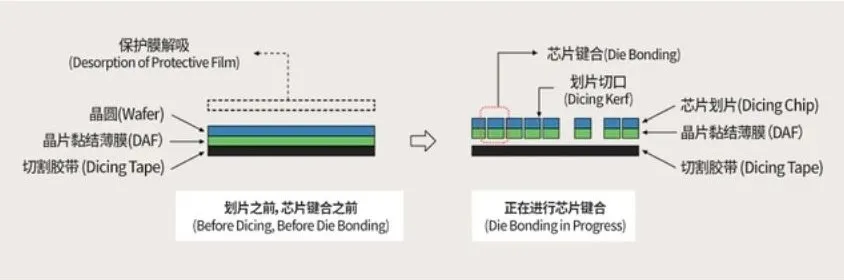
DAF是一種附著在晶粒底部的薄膜。相比液態(tài)黏著劑,采用DAF可將厚度調(diào)整至非常小且恒定的程度。DAF不僅應(yīng)用于芯片和基板之間的鍵合,還廣泛應(yīng)用于芯片與芯片之間的鍵合,從而形成多晶片封裝(MCP)。換句話說,緊密粘合在芯片上的DAF等待切割工藝完成,然后在芯片鍵合過程中發(fā)揮自身的作用。
晶片黏結(jié)薄膜(DAF)的芯片鍵合工藝流程
從切割芯片的結(jié)構(gòu)來看,位于芯片底部的DAF支撐著芯片,而切割膠帶則以弱粘合力牽拉著位于其下方的DAF。在這種結(jié)構(gòu)中,要進(jìn)行芯片鍵合,就需要在移除切割膠帶上的芯片和DAF之后立即將晶粒放置在基板上,并且不得使用環(huán)氧樹脂。由于在此過程中可跳過點膠工序,因此環(huán)氧樹脂的利弊被忽略,取而代之的是DAF的利弊。
使用DAF時,部分空氣會穿透薄膜,形成空洞從而引起薄膜變形等問題。因此,對處理DAF的設(shè)備的精度要求格外高。屹立芯創(chuàng)憑借過硬的技術(shù)水準(zhǔn),以核心技術(shù)為品質(zhì)支撐,運用核心專利技術(shù)進(jìn)一步保證制程穩(wěn)定運行。真空壓力除泡系統(tǒng)VPS使用多重多段真空壓力切換系統(tǒng),可根據(jù)材料特性分段設(shè)定壓力與真空數(shù)值,配備了雙增壓系統(tǒng)和雙溫控保護(hù)系統(tǒng),保證封裝精度及良率。精準(zhǔn)去除氣泡問題的同時,亦可幫助客戶大幅提升UPH、降低生產(chǎn)風(fēng)險與成本、提高產(chǎn)品良率與可靠性。使用DAF膜能夠簡化工藝并提高厚度均勻性,從而降低缺陷率并提高生產(chǎn)率。
屹立芯創(chuàng)DAF貼合工藝應(yīng)用成果
用于放置芯片的基板類型(引線框架或印刷電路板)不同,執(zhí)行芯片鍵合的方向也存在很大差異。相應(yīng)地,隨著鍵合技術(shù)的日益多樣化,用于烘干粘合劑的溫度曲線(Temperature Profile)也在不斷變化。其中一些具有代表性的鍵合方法包括加熱粘接和超聲波粘接。隨著集成技術(shù)的不斷提高,封裝工藝?yán)^續(xù)朝著薄型化方向發(fā)展,封裝技術(shù)也變得多樣化。
電話:4000202002; 13327802009
地址:南京市江北新區(qū)星火北路11號
官網(wǎng):www.3-better.com
郵箱:info@elead-tech.com